半导体晶圆制造工艺介绍
发布日期:2025-01-12 浏览次数:0
八大半导体制造工艺包括:晶圆制造→氧化工艺→光刻工艺→蚀刻工艺→沉积和离子注入工艺→金属化工艺→EDS工艺→封装工艺。本篇文章主要介绍半导体晶圆制造工艺。

以下是硅晶圆的制备流程:1)截断截断如图 1所示,将硅棒的两端去掉,一端为籽晶端(籽晶所在的位置),一端为非籽晶端(与籽晶相对的另一端),即切去单晶硅的头部和尾部。

2)直径研磨由于晶体生长中直径和圆度的控制不可能很精确,所以硅棒都要长得稍大一点,直径的大小也不均匀,所以通常需要进行直径研磨,使单晶硅的直径达到一致以及满足不同产品直径的要求,如图所示。
3) 磨定位面单晶体具有各向异性的特点,必须按特定晶向进行切割,才能满足生产的需要。其原理是用一束可见光或X光射向单晶棒端面,由于端面上晶向的不同,其反射的图形也不同。根据反射图像,可以校正单晶棒的晶向。一旦晶体在切割块上定好晶向,就沿着轴磨滚出一个参考面,通常称为晶圆的主参考面。在许多晶圆中,边缘还会有第二个较小的参考面,称为次参考面,用来区别导电类型。主、次定位边的角度标识了硅片的类型,如图所示。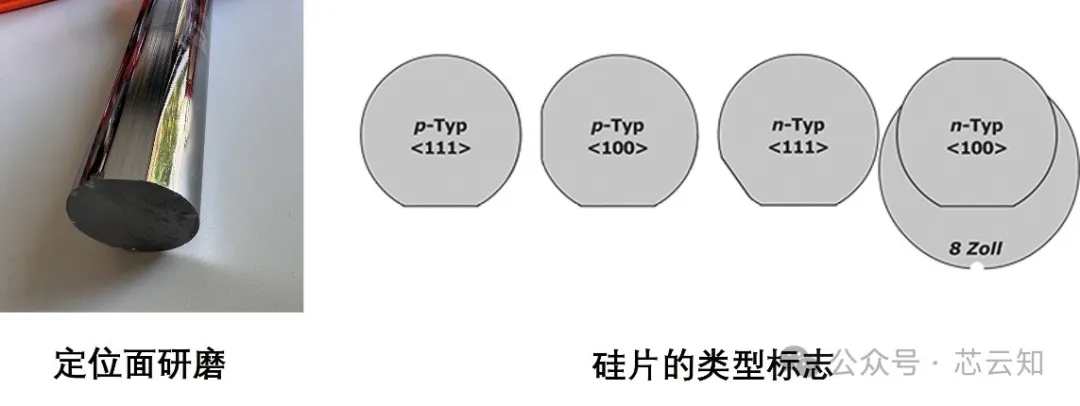
4)切片晶棒的外形处理完之后接着将硅棒切为硅片,切片目前有两种方式,一是用有金刚石涂层的内圆刀片把晶圆从晶体上切下来。这些刀片是中心有圆孔的薄圆钢片。二是线切片,通过粘有金刚石颗粒的金属丝的运动来达到切片的目的。单晶硅在切片时,硅片的厚度、晶向、翘曲度和平行度是关键参数,需要严格控制。晶片切片的要求是: 厚度符合要求,平整度和弯曲度要小,无缺损,无裂缝,刀痕浅。两种方法示意图如图所示。 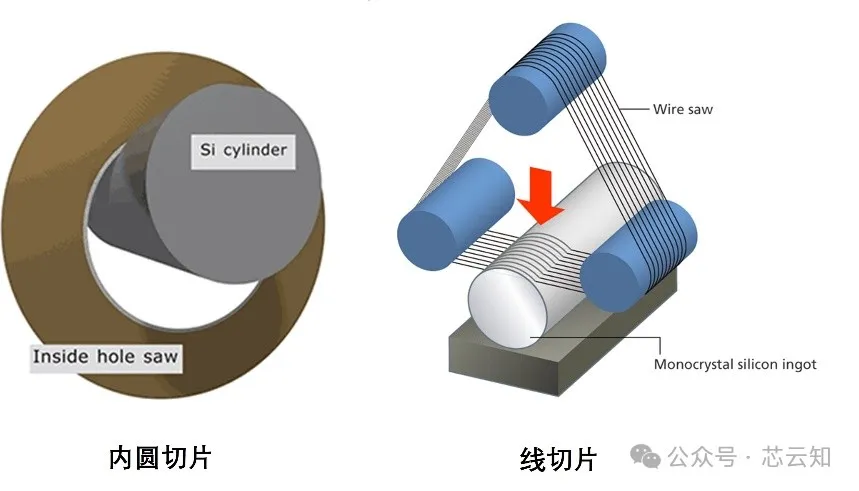
5)磨片切片完成后,对于硅片表面要进行研磨机械加工,其示意图如图5。磨片工艺的目的包括以下两点:一是去除硅片表面的刀疤,使硅片表面加工损伤均匀一致。二是调节硅片厚度,使片与片之间厚度差逐渐缩小,并提高表面平整度和平行度。

目前使用得最普遍的是行星式磨片法,如图6所示。采用双面片机,有上下两块磨板,中间放置行星片,硅片就放在行星片的孔内。磨片时,盘不转动,内齿轮和中心齿轮转动,使行星片与磨盘之间做行星式运动,以带动硅片做行星式运动,在磨料的作用下达到研磨的目的。

6)倒角倒角工艺如图所示,是用具有特定形状的砂轮磨去硅片边缘锋利的崩边、棱角和裂缝等。倒角的目的主要有三个。(1)防止晶圆边缘碎裂。晶圆在制造与使用的过程中,常会受到机械手等撞击而导致晶圆边缘破裂,形成应力集中的区域。这些应力集中的区域会使得晶圆在使用中不断地释放污染粒子,进而影响产品的成品率。(2)防止热应力的集中。晶圆在使用时,会经历无数的高温工艺,如氧化、扩散等,当这些工艺中产生的热应力大小超过硅晶格的强度时,即会产生位错与层错缺陷,晶圆磨边可以避免该类缺陷在晶边产生。(3)增加外延层和光刻胶层在晶圆边缘的平坦度。在外延工艺中,锐角区域的生长速度会比平面高,因此,用没有磨圆的晶圆容易在边缘产生突起。同样,在利用旋转匀胶机涂光刻胶时,光刻胶溶液也会在晶圆边缘发生堆积现象,这些不平整的边缘会影响掩模板对焦的精确性。

7)抛光抛光是硅片表面的最后一道重要加工工序,也是最精细的表面加工。抛光的目的是除去表面细微的损伤层,得到高平整度的光滑表面,如图8所示。最后,得到最终的产品:硅晶圆。
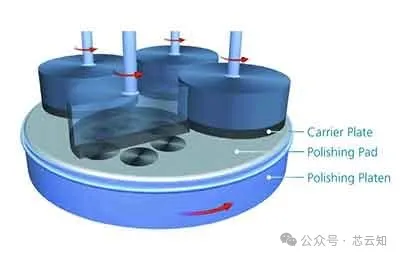
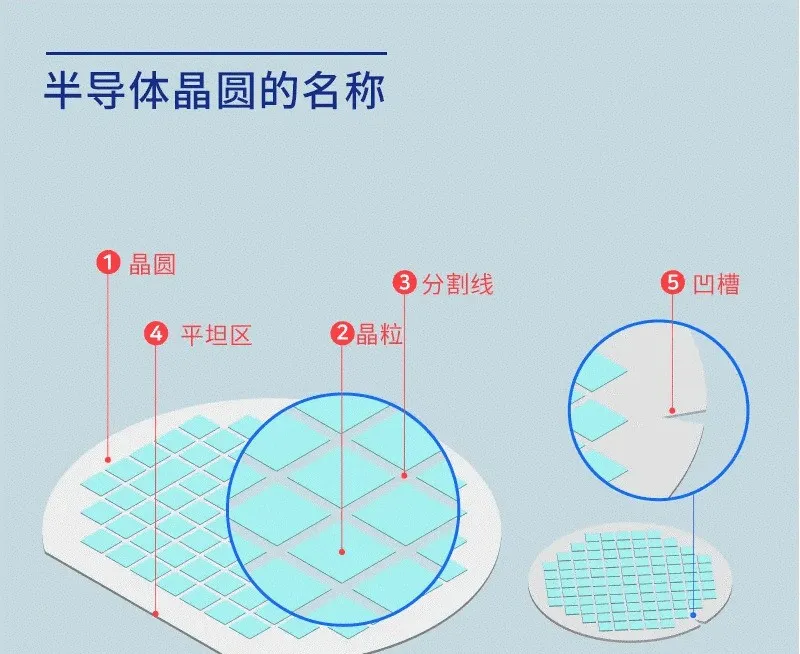
1.晶圆(Wafer):晶圆是半导体集成电路的核心材料,是一种圆形的板。2.晶粒(Die):很多四边形都聚集在圆形晶圆上。这些四边形都是集成电子电路的 IC 芯片。3.分割线(Scribe Line):看上去各个晶粒像是粘在一起,但实际上晶粒和晶粒之间具有一定的间隙。该间距称为分割线。在晶粒和晶粒之间设置分割线的是为了在晶圆加工完成后将这些晶粒一个个割断,然后组装成芯片,也是为了留出用金刚石锯切割的空间。4.平坦区(Flat Zone):平坦区是为区分晶圆结构而创建的区域,是晶圆加工的标准线。由于晶圆的晶体结构非常精细并且无法用肉眼判断,因此以这个平坦区为标准来判断晶圆的垂直和水平。5.凹槽(Notch):如今也出现了具有凹槽的晶圆。和平坦区晶圆相比,凹槽晶圆可以制造更多的晶粒,因此效率很高。半导体产业包括生产晶圆的晶圆产业以及以晶圆为材料设计和制造的晶圆加工产业——制造行业(Fabrication,FAB)。另外,还有组装产业,它将加工过的晶圆切割成晶粒,并包装好以防止受潮或受压。
上一篇:没有了!
下一篇:没有了!






 未登录
未登录


























