半导体抛光工艺
发布日期:2025-01-10 浏览次数:0
抛光工艺分类:
(1)机械抛光法。机械抛光的原理与磨片工艺相同,但其采用的磨料颗料更细些。机械抛光的硅片一般表面平整度较高,但损伤层较深,若采用极细的磨料抛光则速度很慢。目前工业上一般已不采用机械抛光法。
(2)化学抛光法。化学抛光常用硝酸与氢氟酸的混合腐蚀液进行。经化学抛光的硅片表面可以做到没有损伤,抛光速度也较快,但平整度相对较差,因此在工业生产中化学抛光一般作为抛光前的预处理,而不单独作为抛光工艺使用。
(3)化学-机械抛光法。化学-机械抛光法(CMP)利用抛光液对硅片表面的化学腐蚀和机械研磨同时作用,兼有化学抛光和机械抛光两种抛光法的优点,是现代半导体工业中普遍采用的抛光方法。化学-机械抛光法所采用的抛光液一般是由抛光粉和氢氧化钠溶液酿成的胶体溶液,抛光粉通常为SiO2。
由于目前集成电路元件普遍采用多层立体布线,集成电路制造的前道工艺环节需要进行多层循环。在此过程中,需要通过CMP工艺实现晶圆表面的平坦化。CMP就是能有效令集成电路的“楼层”达到纳米级全局平整的一种关键工艺技术。集成电路制造是CMP设备应用的最主要的场景,重复使用在薄膜沉 积后、光刻环节之前;除了集成电路制造,CMP设备还可以用于硅片制造环节与先进封装领域。
抛光机的结构如图所示。贴有硅片的平板安装在抛光机上盘的下面,上盘可以升降和调整压力,下盘是一个直径很大的圆盘,内部需要通水冷却,表面覆盖韧性多孔的聚酯或聚氨酯质的抛光布。抛光时下盘在电动机带动下转动,粘有硅片的平板可绕自己的轴转动,以保证抛光的均匀,抛光液从下盘中央注入,在离心力的作用下向周围散开。抛光过程中由测温仪控制盘温。抛光液中的氢氧化钠起到化学腐蚀的作用,使硅片表面生成硅酸钢盐,通过二氧化硅胶体,对硅片产生机械摩擦,随之又被抛光液带走。这样就实现了去除表面损伤面的抛光作用。
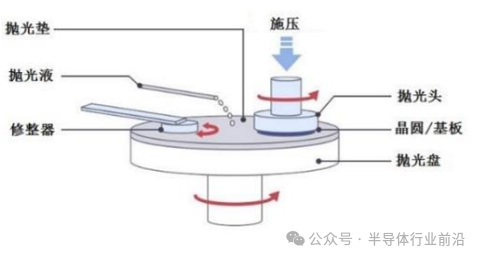
图1 CMP抛光模块示意图
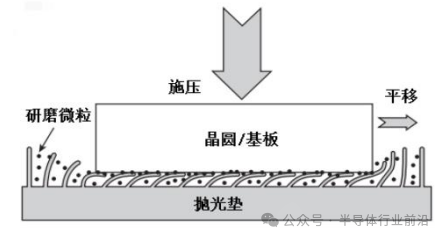
图2 CMP抛光作业原理图
对直径为200mm及更小的硅片来说,仅对上表面进行抛光,背面仍保留化学刻蚀后的表面,这就会在背面留下相对粗糙的表面,大约要比经过化学-机械抛光后的表面粗糙3倍左右。它的目的是提供一个粗糙表面来方便器件传送。
对直径为 300mm 的硅片来说,一般用化学-机械抛光法进行双面抛光(DSP)。硅片在抛光盘之间行星式的运动轨迹在改善表面粗糙度的同时,也使硅片表面平坦且两面平行。抛光后硅片的两面会像镜子一样,抛光后的硅片如图所示。
注意事项:
① 一般来说,硅片需要经过两次抛光,表面才能达到集成电路工艺的要求。第一次抛光一般用氧化镁进行粗抛,其目的是去除硅片表面残留的机械损伤,一般要求从表面除去30μm的厚度。第二次抛光用二氧化硅进行细抛,其目的是去除第一次抛光在硅片表面留下的轻微损伤和云雾状缺陷,要求从表面除去2~3μm的厚度。太阳能电池一般仅用一次抛光即可
② 对硅片进行腐蚀,然后按厚度分档上机抛光。抛光前的工艺过程中须留有足够的可加工余量,以彻底去除硅片表面的机械损伤。
③抛光液浓度对硅片质量的影响。抛光液刚配制好时,其流动性最好,抛光效果也就最好。使用一段时间后,抛光液变稠,会对硅片表面有破坏作用,因此要注意抛光液的使用时间。
④ 硅片上的压强、转速与抛光速度的关系。加在硅片上的压强要恰当,压强太大,则磨削时产生热量多,容易造成粘片;压强太小,抛光速度太慢,硅片表面可能出现枯皮形状。转速太高,易造成摩擦热,化学腐蚀速度增快,使硅片出现腐蚀坑,因此,硅片的压强和转速要控制好。
⑤ 抛光时间与质量的关系。抛光时间不仅与工艺有关,还与质量要求有关。如果磨片十分光洁,而且表面损伤很小,那么抛光时间就缩短些,反之则加长。
CMP发展:
CMP 抛光步骤随着晶圆制造技术进步而不断增加,CMP 抛光材料用量也与晶 圆芯片制程变化高度相关。逻辑芯片方面,14 纳米以下逻辑芯片要求的CMP工艺将达到21步,使用的抛光液将从 90 纳米的五六种抛光液增加到二十种以上,使用 种类和用量都迅速增长;7 纳米及以下逻辑芯片工艺中CMP抛光步骤将会达到30步及以上,使用的抛光液种类接近三十种。存储芯片方面,在由 2DNAND 向 3DNAND 发展的过程中,抛光步骤从 7 步提升到了15步,提升了两倍之多,并且 3DNAND 堆叠层数也会带动 CMP 抛光材料的需求。

图3 CMP抛光步骤的不断发展示意图
抛光垫:
抛光垫是 CMP 实现平坦化的核心部件。抛光垫是一种柔软疏松的材料,一般 由聚氨酯、聚乙烯构成,其表面通常有许多小孔,可以容纳抛光液。抛光垫的作用 主要有存储和运输抛光液、排出抛光过程中产生的废物、去除机械负荷保证抛光的 平稳进行。抛光垫的参数指标,如材质硬度、弹性、压缩比等都起到重要作用,同 时,其表面结构和表面粗糙度可通过影响抛光液流动和分布,来影响抛光效率和平 坦性指标。

图4 CMP抛光垫核心参数

图5 CMP抛光垫分类
抛光液:
抛光液是一种水溶性试剂,主要组成成分有研磨粒子、氧化剂和其他一些化学 试剂。磨料可以是二氧化硅、氧化铝或其他硬质材料;氧化剂可以是过氧化氢、高 锰酸钾或其他强氧化剂;其他化学试剂可以是表面活性剂、络合剂或其他化学物质。其中磨料起到机械磨削的作用,是决定抛光液性能的关键原料。在抛光过程中,抛 光液与硅片表面材料产生化学反应,在其表面产生一层薄膜,后由抛光液中的研磨 粒子在按压和摩擦的作用下将其去除,最终实现抛光。
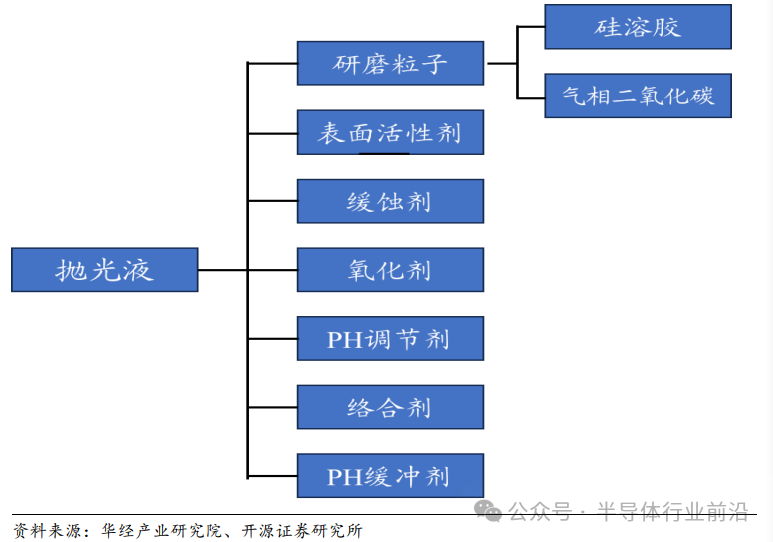
图6 抛光液组成
抛光液种类繁多,定制化产品居多,研磨粒子是关键。根据应用领域的不同, 大致分为硅抛光液、铜及铜阻挡层抛光液、钨抛光液、钴抛光液、层间介质层抛光 液、浅槽隔离层抛光液和 3D 封装硅通孔抛光液。在集成电路制造抛光的过程中,晶 圆厂会根据每一步晶圆芯片平坦度的加工要求,选择符合去除率和表面粗糙度等相 关指标要求的 CMP 抛光液,来提升其良率,因此研磨液中的研磨粒子是关键。
上一篇:没有了!
下一篇:没有了!






 未登录
未登录


























